新一代2.5D先进封装来了 三星推出H-Cube封装解决方案
2021-11-11 11:23:23爱云资讯780
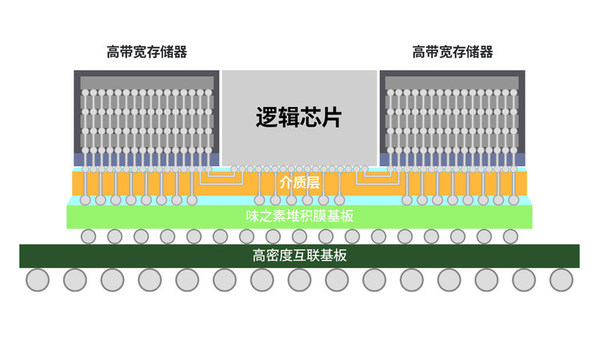
三星H-Cube封装解决方案
“H-Cube是三星电机(Samsung Electro-Mechanics, SEMCO) 和 Amkor Technology公司共同开发的成功案例。该封装解决方案适用于需要集成大量硅片的高性能芯片”,三星电子晶圆代工市场战略部高级副总裁Moonsoo Kang表示,“通过扩大和丰富代工生态系统,我们将提供丰富的封装解决方案,帮助客户突破挑战。”
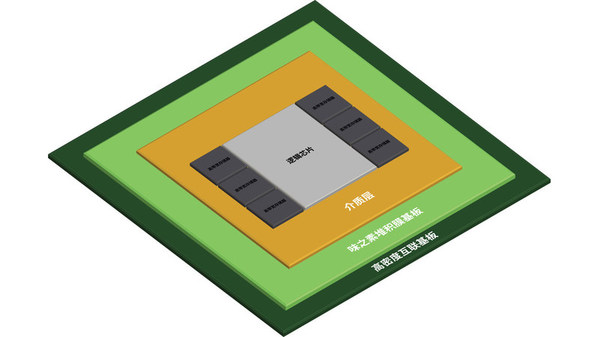
三星H-Cube封装解决方案
“现如今,在对系统集成要求日益提升、大型基板供应困难的情况下,三星晶圆代工厂和Amkor Technology公司成功地联合开发了H-Cube(Hybrid Substrate Cube,混合基板封装)技术,以应对挑战。H-Cube降低了HPC/AI市场的准入门槛,晶圆代工厂和OSAT(Outsourced Semiconductor Assembly and Test)公司之间的合作也很成功。”Amkor Technology全球研发中心高级副总裁JinYoung Kim表示。
H-Cube结构和特点
2.5D封装技术,通过硅中介层把逻辑芯片和高带宽内存芯片集成于方寸之间。三星H-CubeTM封装解决方案,通过整合两种具有不同特点的基板:精细化的ABF(Ajinomoto Build-up Film,味之素堆积膜)基板,以及HDI(High Density Interconnection,高密度互连)基板,可以进一步实现更大的2.5D封装。
随着现代高性能计算、人工智能和网络处理芯片的规格要求越来越高,需要封装在一起的芯片数量和面积剧增,带宽需求日益增高,使得大尺寸的封装变得越来越重要。其中关键的ABF基板,由于尺寸变大,价格也随之剧增。
特别是在集成6个或以上的HBM的情况下,制造大面积ABF基板的难度剧增,导致生产效率降低。我们通过采用在高端ABF基板上叠加大面积的HDI基板的结构,很好解决了这一难题。
通过将连接芯片和基板的焊锡球的间距缩短35%,可以缩小ABF基板的尺寸,同时在ABF基板下添加HDI基板以确保与系统板的连接。
此外,通过三星专有的信号/电源完整性分析,即便在集成多个逻辑芯片和HBM的情况下,H-Cube也能稳定供电和传输信号,而减少损耗或失真,从而增强了该解决方案的可靠性。
与此同时,以加强与生态系统伙伴的合作,代工生态系统三星将于11月18日在线举办其第三届“SAFETM(三星先进代工生态系统)论坛”。
可通过访问官网,提前报名参加论坛。https://www.samsungfoundry.com
*本文中的产品图片以及型号、数据、功能、性能、规格参数等仅供参考,三星有可能对上述内容进行改进,具体信息请参照产品实物、产品说明书或三星官网(www.samsung.com/cn)。除非经特殊说明,本网站中所涉及的数据均为三星内部测试结果,涉及的对比均为与三星产品相比较。
相关文章
- 三星9100 PRO PCIe 5.0 NVMe M.2 固态硬盘评测:PCIe 5.0时代的性能巅峰
- 三星宣布Samsung One UI 7将于4月正式推出
- 三星以生态之力,共筑AI未来
- TCL华星供屏三星玄龙骑士G90XF,打造裸眼3D电竞新标杆
- 中国三星与供应链协同发展 共筑可持续发展未来
- 三星或于今年推出AI智能眼镜
- Galaxy AI闪耀AWE 2025 三星引领移动科技创新潮流
- 深圳印发重磅新政《行动计划》,三星/腾讯/微美全息强化AI优势构筑护城河
- 三星MWC2025:以AI赋能未来智能生活新画卷
- 三星Galaxy Z Flip 7折叠手机渲染图再度曝光:全屏外屏
- 三星携Galaxy AI和以软件为中心的网络技术亮相MWC 2025,进一步强化移动AI领先优势
- 美光LPDDR5X技术大爆发,三星Galaxy成功落实运用
- AI本土化版图再拓展 三星Galaxy S25系列支持DeepSeek-R1
- 接入DeepSeek-R1!三星Galaxy S25系列AI能力再加强
- 三星可拉伸屏幕 探索未来显示新形态
- 智能焕新 国补加持 三星Galaxy S25打造满格旗舰体验






