3D封装技术突破!台积电、英特尔积极引领
2019-08-12 14:25:23爱云资讯647
针对HPC芯片封装技术,台积电已在2019年6月于日本VLSI技术及电路研讨会(2019 Symposia on VLSI Technology & Circuits)中,提出新型态SoIC(System on Integrated Chips)之3D封装技术论文;透过微缩凸块(Bumping)密度,提升CPU/GPU处理器与存储器间整体运算速度。
整体而言,期望借由SoIC封装技术持续延伸,并作为台积电于InFO(Integrated Fan-out)、CoWoS(Chip on Wafer on Substrate)后端先进封装之全新解决方案。
运用垂直叠合与微缩体积方法,3D封装成功提升HPC工作效率
由于半导体发展技术的突破、元件尺寸逐渐微缩之际,驱使HPC芯片封装发展必须考量封装所需之体积与芯片效能的提升,因此对HPC芯片封装技术的未来发展趋势,除了现有的扇出型晶圆级封装(FOWLP)与2.5D封装外,将朝向技术难度更高的3D封装技术为开发目标。
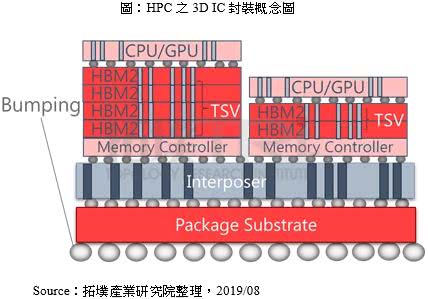
所谓的3D封装技术,主要为求再次提升AI之HPC芯片的运算速度及能力,试图将HBM高频宽存储器与CPU/GPU/FPGA/NPU处理器彼此整合,并藉由高端TSV(硅穿孔)技术,同时将两者垂直叠合于一起,减小彼此的传输路径、加速处理与运算速度,提高整体HPC芯片的工作效率。
台积电与Intel积极推出3D封装,将引领代工封测厂一并跟进
依现行3D封装技术,由于必须垂直叠合HPC芯片内的处理器及存储器,因此就开发成本而言,比其他两者封装技术(FOWLP、2.5D封装)高出许多,制程难度上也更复杂、成品良率较低。

目前3D封装技术已对外公告的最新成果,现阶段除了半导体代工制造龙头台积电最积极,已宣布预计于2020年导入量产SoIC和WoW(Wafer on Wafer)等3D封装技术外,另有IDM大厂Intel也提出Foveros之3D封装概念,将于2019下半年迎战后续处理器与HPC芯片之封装市场。
随着半导体代工制造商与IDM厂陆续针对3D封装技术投入研发资源,也将引领另一波3D封测技术风潮,相信代工封测厂(如日月光、Amkor等)也将加紧脚步,跟上此波3D封装技术的发展趋势。
相关文章
- 国亦生命战略赋能全球首款3D间充质干细胞注射液获批IND
- 创想三维11周年店庆,3D打印机享国补+百亿补贴,惊喜上线
- 精准·高效·革新丨RAYSHAPE发布Edge mini 3D打印机,开启椅旁数字化诊疗新纪元
- 长城哈弗H6 PHEV搭载花瓣地图亮相泰国车展,带来3D车道级导航体验
- TCL华星供屏三星玄龙骑士G90XF,打造裸眼3D电竞新标杆
- 3D打印数智赋能!铼赛智能P400亮相华为中国合作伙伴大会2025
- 全球首部虚幻引擎电影《恶兽》上线,全部布料解算来自Style3D
- 增材制造技术重塑鞋业新生态,Formnext深圳展3D打印鞋业应用论坛
- 展会回顾丨铼赛智能携新品Edge mini亮相TCT ASIA,引领医疗3D打印新潮流
- 纵维立方Kobra S1 Combo闪耀2025上海TCT展会 消费级多色3D打印机获市场高度认可
- 上体大史仍飞教授团队:解锁健康饮食密码,SAT-3D开启减重干预新篇章
- 9950X3D力破9霄 华硕X870/X870E主板绝佳拍档
- AMD锐龙9950X3D处理器京东首销火爆 北京首位预售用户已收到货
- Style3D发布时尚产业AI智能体,内测版引发CHIC展震动
- AMD锐龙9 9950X3D和9900X3D游戏处理器将于3月12日上市
- Formnext 2025深圳展打造华南大湾区3D打印技术辐射中枢






